
 启闳半导体科技(江苏)有限公司
启闳半导体科技(江苏)有限公司圆片清洗是指在不造成伤害的情况下去除附着于圆片表面的异物的工艺。清洗工艺分为湿法和干法两大类。干法清洗是指异物去除的过程在气态中完成,其设备统称为干法清洗设备。在现代集成电路生产线上,清洗设备往往还包含圆片的表面处理的功能,以利于后续工艺或圆片储藏。异物主要有微尘颗粒、有机物和金属等,其来源多样,包括前一道工序中产生的反应生成物(如刻蚀工艺所留下的聚合物)、反应腔部件产生的杂质(如镀层损伤剥落和润滑剂挥发),以及由人员操作、圆片传输及存储环境导致的交叉污染(如汗水、纤维)等。
相对于湿法清洗,干法清洗的优点主要有如下5点。
(1)消除了由液体表面张力导致的对集成电路结构的静摩擦损坏(Sicin)及崩塌(Collapse) 效应。
(2)清洗后的残留物较少,对清洗后的水洗及干燥的依赖较小。
(3)气体清洗剂的颗粒比较小,容易清洗深宽比较大的结构,这在先进工艺中尤为重要。
(4)比较安全和环保。
(5)易于和其他设备整合在同一个主机系统(Manfrme Sytem)中,从而实现模块式操作,提高生产效率。
干法清洗去除圆片表面异物的机理可以简单归纳为3种,如图8-157 所示。
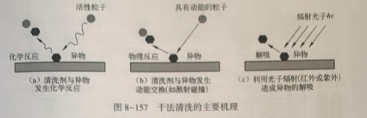
干法清洗设备可以大致分为如下5种。
(1)等离子体清洗设备:利用等离子体产生的活性粒子与圆片表面异物发生化学反应加以清除(如用氧气等离子体清洗刻蚀残留的聚合物),或者利用等离子体中带有动能的离子减射异物加以清除( 如氧气等离子体可用于PVD沉积前的表面清洗)。这种设备往往与去光刻胶设备( Petoresist Siping)或带有偏压电源的离子反应刻蚀设备类似。
(2) 蒸气态清洗(Vapor Phase Cleaing) 设备:它又分为用于清洗氧化物的氟化氢(HF Vapor)蒸气清洗设备,用于清洗有机物的紫外线/臭氧(UV/0,)蒸气清洗设备,以及用于清洗金属复合物的紫外线/氧气(UV/C2)清洗设备。汽化的清洗制更容易进出微细结构面且往往其活化性更高,所以清洗效率较高。
(3)低温喷雾清洗(Cryogenic Aerosel Cleaning) 设备:通过冷却而呈气液井存态的稀有气体(如氢气、氮气),经由高压喷头喷人相对低压的工作室,瞬问膨胀的稀有气液体转化为结晶态的烟雾族(Aerosod Chaster),与圆片上的微粒发生作用,达到去除微粒的目的。这。 清洗方式不会造成附加的化学反应( Reaetion)、锈蚀(Corrosion) 及损伤(Damge). 尤其是对铜互连时代所采用的低居介质材料的清洗损害最小。图8- 158所示的是低温喷雾清洗设备的简化示意图”。
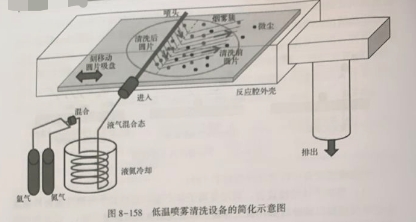
(4)超临界流体清洗( Supereritical Fluid Cleaning) 设备:是指在临界温度和临界压力下,使用具有液体和气体中间特性状态的流体(如处于约31C和
74atm下的二氧化碳)作为清快剂的清洗,由于其點性和表面张力低,扩散速率快,易于溶解异物以使其剥离。
(5)其他定点去除异物的清洗设备:一股需要与检测微尘位置的装置配合使用,包括激光照射(Laser Iradiation)、 原子力显微镜纳米扫除( AFM NanoSuerping)和纳米慑子(Nano Teer Pick-Up)等。
在集成电路前段工艺步骤数量中,清洗约占20% - 30%,是相当重要的环节。面干法清洗在现代工艺的清洗中约占10%。随着集成电路的小型化和立体化发展,干法清洗可能会得到更广泛的应用,其设备比率也将呈上升的趋势。表8-44列出了干法清洗的主要应用。

干法清洗的主要弱点是其清洗强度不如湿法清洗中的化学液体,所以清洗效率不够高,尤其是对超小尺寸的微尘的清洗。干法清洗也难以满足先进工艺对去除金属污染的要求。此外,对大量或大面积异物的清洗,如化学机械抛光(Cremial Mchaiea Posking CMP)后的清洗,干法清洗的效果不够好。
